[Fundamental of Power Electronics]-PART I-4.开关实现-4.2 功率半导体器件概述
4.2 功率半导体器件概述
功率半导体设计中最根本的挑战是获得高击穿电压,同时保持低正向压降和导通电阻。一个密切相关的问题是高压低导通电阻器件的开关时间更长。击穿电压,导通电阻和开关时间之间的折衷是各种功率器件的关键区别特征。
反向偏置的PN结及其相关的耗尽区的击穿电压是掺杂程度的函数:在PN结的至少一侧的材料中,获得高击穿电压需要低掺杂浓度,从而导致高电阻率。该高电阻率区域通常是设备导通电阻的主要贡献者,因此高压设备必定具有比低压设备更高的导通电阻。在多数载流子元件(单极型器件)中(包括MOSFET和肖特基二极管),这说明了导通电阻对额定电压的一阶依赖性。但是,少数载流子元件(双极型器件),包括扩散PN结二极管,双极结型晶体管(BJT),绝缘栅双极型晶体管(IGBT)和晶闸管系列(SCR,GTO,MCT),表现出另一种已知电导率调制现象。当少数载流子元件在导通状态下工作时,少数载流子将通过正向偏置的PN结注入轻掺杂的高电阻率区域。所产生的高浓度的少数载流子有效地减小了该区域的电阻率,从而减小了器件的导通电阻。因此,少数载流子元件显示出比同类多数载流子元件更低的导通电阻。
但是,少数载流子元件的导通电阻降低的优点带来了开关速度降低的缺点。任何半导体器件的导通状态都由该器件内部是否存在主导电荷量来控制,并且导通和关断切换时间等于插入或移除该控制电荷所需的时间。通过电导调制效应工作的元件由其注入的少数载流子控制。控制少数载流子元件中的少数电荷的总量远大于控制等效多数载流子元件所需的电荷。尽管用于插入和移除各种元件控制电荷的机制可能有所不同,但事实是,由于少数载流子元件的电荷量很大,因此其开关时间明显比多数载流子元件的切换时间长。因此,多数载流子元件在较低的电压电平和较高的开关频率下得以应用,而少数载流子元件则相反。
现代功率器件是用最新的加工技术制造的。由此产生的较小特征尺寸允许构建高度复杂的器件,其不需要的寄生参数不那么重要。由此产生的设备比之前的器件更加坚固和性能良好。
对功率半导体器件物理和开关机制的详细描述超出了本书的范围。参考章节中列出了有关功率半导体器件的选定参考文献[9-19]。
译者:半导体相关知识欠缺,较多专业术语可能错误,本节供读者参考交流,如能提供勘误,不胜感激
4.2.1 功率二极管
如上所述,扩散结PN二极管包含一个轻掺杂或本征高阻区,这使得其可以获得高击穿电压。如图4.24(a)所示,这个区域包括\(P-N^{-}\)结的一边(表示为\(N^{-}\))。在反向偏置条件下,基本上所有的外加电压都出现在\(N^{-}\)区域内的耗尽区内。导通条件如图4.24(b)所示,空穴穿过正向偏压结注入,成为\(N^{-}\)区域的少数载流子。这些少数载流子通过电导调制有效地降低了\(N^{-}\)区的视在电阻率(应该意为净电阻率)。基本上所有的正向电流\(i(t)\)都是由穿过\(P-N\)区的空穴组成,然后与\(N\)区的电子重新结合。
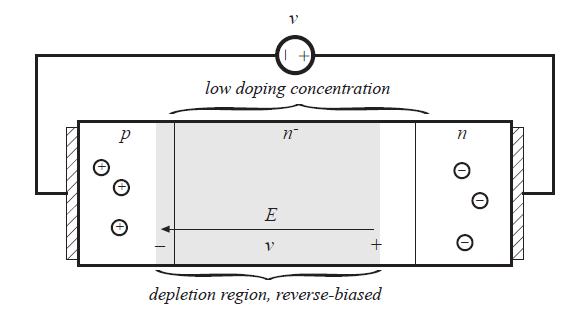
(a)
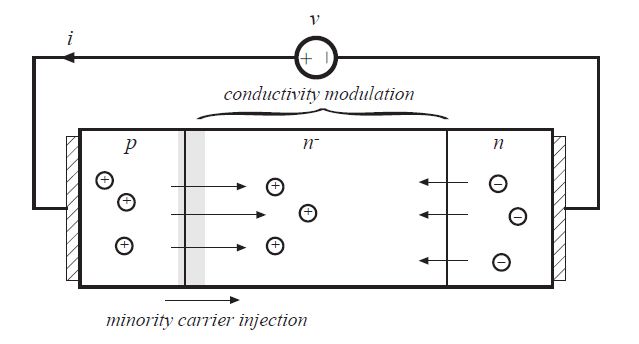
(b)
Fig 4.24 Power diode :(a) under reverse-bias conditions,(b) under forward-bias conditions
典型的开关波形如图4.25所示。\(P-N\)二极管常见的指数\(i-v\)特性是一个平衡关系。在瞬态过程中,观察到指数特性的显著偏差;这些偏差与储存的少数电荷的变化有关。如图4.25所示,二极管在区间(1)期间处于截止状态,电流为零,电压为负。在区间(2)的开始,电流增加到某个正值。该电流为反向偏置二极管的有效电容充电,将电荷提供给耗尽区并增加电压\(v(t)\)。最终,电压变为正,二极管结变为正向偏置。电压可能上升到几伏或甚至几十伏的峰值,反映出轻掺杂\(N^-\)区的电阻有些大。正向偏置的\(P-N^-\)结继续向\(N^-\)区域注入少数电荷。随着\(N^-\)区域中总的少数电荷增加,\(N^-\)区域的电导调制会导致其有效电阻降低,因此正向电压降$v(t) \(也降低。最终,二极管达到平衡,其中少数载流子注入速率和复合速率相等。在区间(3)内,二极管工作在导通状态,正向压降由二极管静态\)i–v$特性给出。

Fig 4.25 Diode voltage and current waveforms
关断瞬态在区间(4)的起始处开始。当二极管\(P-N^-\) 结附近存在少量电荷时,二极管保持正向偏置。存储的少数电荷的减少可以由有源方式,通过负端子电流或由无源方式,通过复合来实现。通常,两种机制同时发生。二极管关断电流波形的负数部分中包含的电荷\(Q_r\)称为恢复电荷。在区间(4)期间出现的\(Q_r\)部分是主动去除的少数电荷。在区间(4)的末尾,\(P-N^-\)结附近存储的少数电荷已被去除,从而使二极管结变为反向偏置并能够阻断负电压。然后在时间间隔(5)内将耗尽区有效电容充电至负断态电压。在区间(5)期间出现的\(Q_r\)部分被提供给耗尽区,以及少数电荷被主动从二极管的较远区域清除。在区间(5)结束时,二极管能够阻止整个施加的反向电压。区间(4)和(5)的长度称为反向恢复时间\(t_r\)。在区间(6)内,二极管工作在截止状态。二极管关断变换及其对PWM变换器中开关损耗的影响将在4.3.2节中进一步讨论。
二极管根据其反向恢复时间的长短来定额。标准恢复整流器(Standard recovery)适用于50 Hz或60 Hz的工作频率。通常不指定这些设备的反向恢复时间。快恢复(Fast recovery )整流器和超快恢复整流器旨在用于转换器应用。这些设备的制造商规定了反向恢复时间\(t_r\),有时还包括恢复的电荷\(Q_r\)。表4.1列出了几种商用设备的额定值。
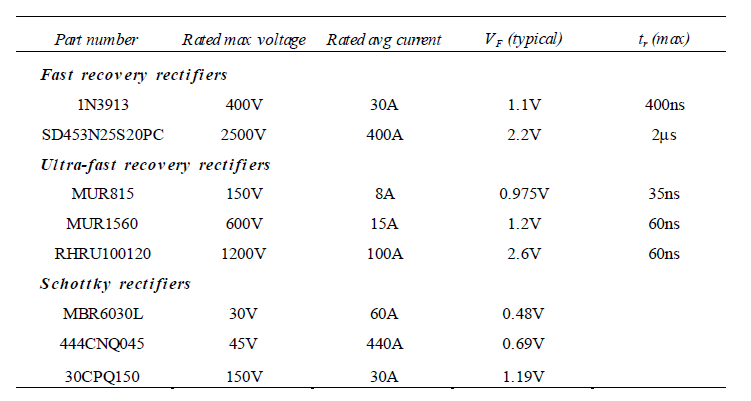
Table 4.1 Characteristics of several commercial power rectifier diodes
肖特基二极管本质上是多数载流子元件,其工作基于金属-半导体结的整流特性。这些器件的少数存储电荷可忽略不计,并且它们的开关行为可以通过其耗尽区电容和平衡指数\(i–v\)特性进行简单建模。因此,肖特基二极管的优点是其快速的开关速度。肖特基二极管的一个甚至更重要的优点是其正向压降低,尤其是在额定电压为45 V或更低的器件中。肖特基二极管仅限于低击穿电压。极少数商用设备的额定电压为100 V或更高。它们的截止状态反向电流比\(P-N\)结二极管的反向电流大得多。表4.1中还列出了几种商用肖特基整流器的特性。
功率半导体器件的另一个重要特性是其导通电阻和正向压降是否呈现正温度系数。这样的器件(包括MOSFET和IGBT)特性是有利的,因为可以轻松地并联多个芯片以获得大电流模块。这些设备也更坚固耐用,不易出现热击穿和二次击穿问题。二极管由于其负温度系数而无法轻松地并联:器件特性的不平衡可能导致一个二极管传导的电流大于其他二极管。该二极管变热,导致其传导的电流甚至更多。结果,电流在并联的器件之间不能平均分配,并且可能会超出器件之一的额定电流。由于BJT和晶闸管是由二极管结控制的,因此这些器件也具有负温度系数,并且在并联运行时也会遇到类似的问题。当然,可以并联任何类型的半导体器件。但是,可能需要使用匹配的器件,共用的热基板和/或外部电路,以使器件的导通电流相等。
4.2.2 金属氧化物半导体场效应晶体管(MOSFET)

Fig 4.26 Cross-section of DMOS n-channel power MOSFET structure. Crosshatched regions are mentallized contacts. Shaded regions are insulating silicon dioxide layers.
功率MOSFET是一种现代功率半导体器件,其栅极长度接近1微米。该功率器件由许多小的并联增强模式MOSFET单元组成,这些单元覆盖了硅片的表面。一个单元的横截面如图4.26所示。电流垂直流过硅晶片:金属化的漏极连接位于芯片的底部,而金属化的源极连接和多晶硅栅极位于顶部表面。在正常工作条件下,$v_{ds} \geq 0 \(,\)P-N\(和\)P-N-$结都反偏。图4.27(a)说明了处于关断状态的元件的工作。施加的漏-源电压在$P-N-\(结的耗尽区两端。\)N-$区是轻掺杂的,从而获得所需的击穿电压额定值。图4.27(b)说明了在导通状态下的工作时具有足够大的正栅-源电压。然后在栅极下方的$P$区域的表面形成一个沟道。漏极电流流经$N-\(区域,沟道,\)N\(区域,并通过源极触点流出。器件的导通电阻是\)N-$区域,沟道,源极和漏极触点等的电阻之和。随着击穿电压的增加,导通电阻由$N-$区域的电阻决定。由于没有少数载流子引起电导调制,因此当击穿电压增加到几百伏甚至更高时,导通电阻会迅速增加。
\(P-N^-\)结称为体二极管;如图4.27(c)所示,该结形成一个与MOSFET沟道并联的有效二极管。当漏极至源极的电压\(v_{ds}(t)\)为负时,体二极管可能会变为正向偏置。该二极管能够传导MOSFET的全部额定电流。但是,大多数MOSFET的体二极管的速度并未得到优化,体二极管的反向恢复瞬态期间流过的大峰值电流会导致器件故障。多家制造商生产的MOSFET包含快速恢复的体二极管。这些器件的额定值可承受体二极管反向恢复过渡期间的峰值电流。
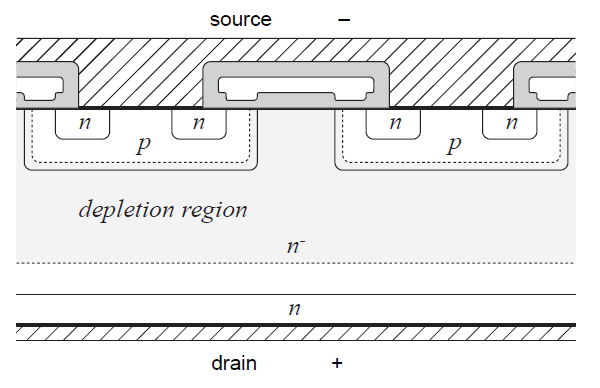
(a)
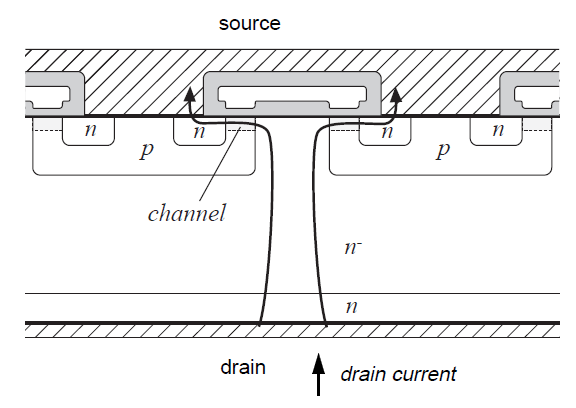
(b)
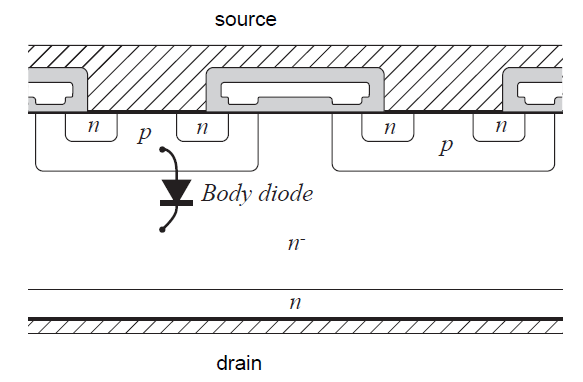
(c)
Fig 4.27 Operation of the power MOSFET :(a) in the off state,\(v_{ds}\) appears across the depletion region in the \(N^-\) region (b) current flow through the conducting channel in the on state ;(c) body diode due to the \(P-N^-\) junction
典型的N沟道MOSFET静态开关特性如图4.28所示。对于漏极-源极电压的各种值,将漏极电流绘制成栅极-源极电压的函数。当栅极至源极电压小于阈值电压\(V_{th}\)时,器件将工作在截止状态。\(V_{th}\)的典型值为3 V。当栅源电压大于6或者7 V时,器件工作于导通状态。通常,栅极会驱动至12 V或者15 V来保证正向压降的最小。在导通状态下,漏源电压\(V_{DS}\)大致与漏极电流\(I_{D}\)成正比。MOSFET能够传导远远超过其平均额定电流的峰值电流,并且静态特性的性质在高电流水平下保持不变。还提供逻辑级功率MOSFET,它们在导通状态下的栅极至源极电压为5V。可以得到一些\(P\)沟道器件,但其性能不如等效的\(N\)沟道器件。
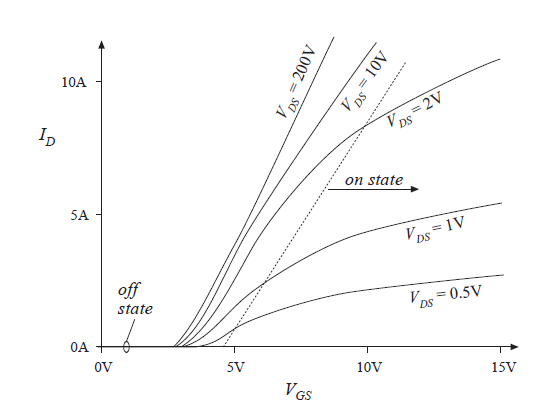
Fig 4.28 Typical characteristics of a power MOSFET. Drain current \(I_{D}\) is plotted vs. gate-to-source voltage \(V_{gs}\), for various values of drain-to-source voltage \(V_{DS}\)
MOSFET的导通电阻和正向压降具有正温度系数。此特性使器件并联相对容易。可以通过包含几个并连的芯片,得到大电流MOSFET模块。
MOSFET的主要电容如图4.29所示。该模型足以定性地了解MOSFET的开关行为;更精确的模型说明了DMOS几何结构固有的寄生结场效应晶体管。MOSFET的开关时间主要取决于栅极驱动器为这些电容充电所需的时间。由于漏极电流是栅极-源极电压的函数,因此漏极电流变化的速率取决于栅极驱动电路对栅极-源极电容充电的速率。同样,漏极电压变化的速率是栅极-漏极电容充电的速率的函数。漏源电容直接导致PWM变换器的开关损耗,因为存储在该电容中的能量在晶体管导通过渡期间会丢失。开关损耗在第4.3节中讨论。
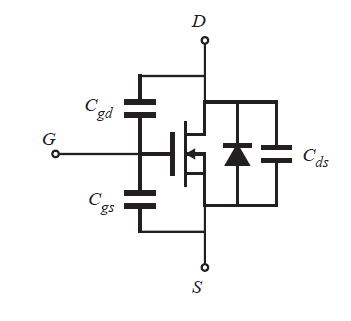
Fig 4.29 MOSFET equivalent circuit which accounts for the body diode and effective terminal capacitances
栅极到源极的电容基本上是线性的。但是,漏极至源极和栅极至漏极的电容是强烈非线性的:这些增量电容随所施加电容电压的平方根的倒数而变化。例如,对漏源电容增量的依赖性可以用以下形式表示:
\]
其中\(C_{0}\)和\(v_{0}\)是取决于器件结构的常数。当\(v_{ds}\)在其正常工作范围内变化时,这些电容很容易变化几个数量级。当\(v_{ds}>>V_{0}\)时,式(4.4)可近似为:
\]
这些表达式在4.3.3节中用于确定由于存储在其中的能量而引起的开关损耗。
表4.2列出了几种市售功率MOSFET的参数。栅极电荷\(Q_g\)是栅极驱动电路必须提供给MOSFET的电荷,以将栅极电压从零升高到某个指定值(通常为10 V),并且具有关断状态的漏极至源极电压的指定值(通常为\(V_{DS}\)额定值的80%)。栅极总电荷是栅极至漏极和栅极至源极电容上电荷的总和。总栅极电荷在某种程度上是MOSFET尺寸和开关速度的量度。
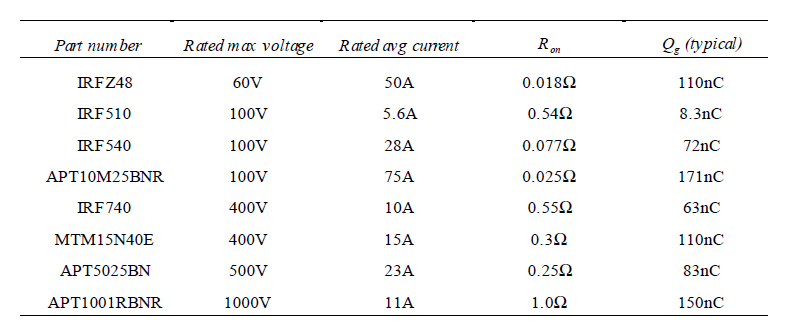
Table 4.2 Characteristics of several commercial N-channel power MOSFETs
与其他功率器件不同,通常不根据其额定电流来选择MOSFET。实际上,导通电阻及其对导通损耗的影响是限制性因素,并且,MOSFET通常以略小于额定值的平均电流工作。
MOSFET通常是在小于或约等于400至500 V电压下选择的器件。在这些电压下,其正向电压降与少数载流子器件(双极型器件)相比更具有优势且其开关速度更快。典型的开关时间在50 ns至200 ns的范围内。在大于400至500 V的电压下,通常优选具有较低正向压降的少数载流子器件,例如IGBT。唯一的例外是在高开关速度超过获得可接受的低传导损耗所需的硅成本增加的应用中。
4.2.3 双极结型晶体管(BJT)
NPN型功率BJT的横截面如图4.30所示。与其他功率器件一样,电流垂直流过硅晶片。将轻掺杂的\(N^-\)区插入集电极中,以获得所需的电压击穿额定值。当\(P-N\)基极-发射极结和\(P-N^-\)基极-集电极结反向偏置时,晶体管工作在截止状态(截止)。然后,施加的集电极-发射极电压基本上出现在\(P-N^-\)结的耗尽区两端。当两个结都正向偏置时,晶体管将处于导通状态(饱和)。然后在\(P\)和\(N^-\)区域中充满少数电荷(少子)。这种少数电荷通过电导率调制效应使该区域表现出低导通电阻。在截止状态和导通状态之间是熟悉的有源区(active region),其中,\(P-N\)基极-发射极结被正向偏置,而\(P-N^-\)基极-集电极结被反向偏置。当BJT在有源区工作时,集电极电流与基极区少数电荷(少子)成正比,而电荷又与基极电流成比例(处于平衡状态)。在有源区和饱和区之间还存在一个称为准饱和的第四工作区。当基极电流不足以使器件完全饱和时,就会发生准饱和。因此,存在于\(N^-\)区中的少数电荷不足以完全减小\(N^-\)区电阻,并且观察到高的晶体管导通电阻。
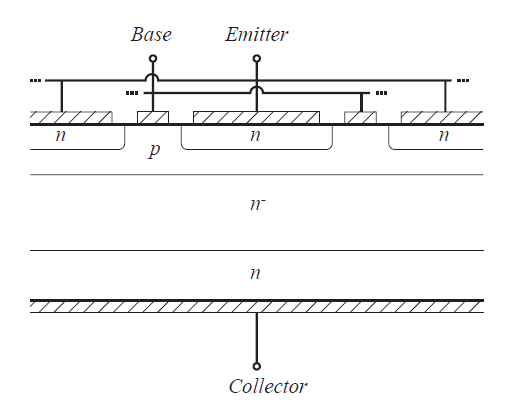
Fig 4.30 Power BJT structure. Crosshatched regions are metalized contacts
考虑图4.31的简单开关电路。图4.32包含说明BJT导通和关断转换的波形。晶体管在间隔(1)期间处于截止状态,基极-发射极结被源极电压\(v_{s}(t)=-V_{s1}\)反向偏置。当电源电压变为\(v_{s}(t) = +V_{s2}\)时,间隔(2)开始时启动导通过渡。然后由电源将正电流提供给BJT的基极。该电流首先为反向偏置的基极-发射极和基极-集电极结的耗尽区的电容充电。在间隔(2)结束时,基极-发射极电压超过零,足以使基极-发射极结变为正向偏置。间隔(2)的长度称为导通延迟时间。在时间间隔(3)内,少数电荷从发射极跨过基极-发射极结注入基极区。集电极电流与该少数基极电荷成正比。因此在间隔(3)期间,集电极电流增加。由于晶体管驱动电阻负载\(R_{L}\)因此集电极电压在间隔(3)期间也会降低。这会导致在反向偏置的基极-集电极耗尽区(Miller 电容)电容上电压降低。增加基极电流\(I_{B1}\)(通过减小\(R_{B}\)或\(V_{s2}\)来增加)会同时增加基极区少数电荷和米勒电容中电荷的变化率。因此增加\(I_{B1}\)使得导通切换时间减小。

Fig 4.31 Circuit for BJT switching time example

Fig 4.32 BJT turn-on and turn-off transition waveforms
在时间间隔(3)结束附近,基极-集电极\(P-N^-\)结变为正向偏置。然后将少数载流子注入\(N^-\)区域,从而降低其有效电阻率。取决于器件的几何形状和基极电流的大小,随着区域的视在电阻通过电导调制而减小,可以观察到电压拖尾[间隔(4)]。BJT在间隔(5)的开始时达到导通状态平衡,导通电阻低并且在\(N^-\)和\(P\)区域都充满少数电荷(少子)这种少数电荷大大超过了支持集电极电流\(I_{Con}\)有源区传导所需的量。其幅度是\(I_{B1}-I_{Con}/{\beta}\)的函数,其中\(\beta\)为有源区电流增益。在间隔(6)的开始处启动关断过程,此时电压为\(v_{s}(t) = -V_{s1}\)。只要附近有少数载流子,基极-发射极结就会保持正向偏置。只要少数电荷超过支持有源区导通所需的电流\(I_{Con}\),也就是说,只要存在多余的电荷,集电极电流就会持续为\(i_{C}(t)=i_{Con}\)。因此在间隔(6)期间,负的基极电流流过等于\(-I_{B2}=(-V_{s1}-v_{BE}(t))/R_{B}\)。该负的基极电流会主动消除总存储的少数电荷。重组进一步减少了少数电荷。当所有多余的少数电荷均已消除时,间隔(6)结束。间隔(6)的长度称为存储时间。在间隔(7)期间,晶体管在有源区域中工作。现在,集电极电流\(i_{C}(t)\)与存储的少数电荷成正比。重组和负基极电流继续减少少数基极电荷,因此集电极减小。另外,集电极电压增加,因此基极电流必须给米勒电容充电。在间隔(7)结束时,少数存储电荷等于零,并且基极-发射极结可能会变为反向偏置。间隔(7)的长度称为关断时间或下降时间。在间隔(8)中,反向偏置的基极-发射极结电容放电至电压\(-V_{s1}\)。在间隔(9)中,晶体管在截止状态下处于平衡状态。
当\(I_{B2}=0\)时,晶体管可以关闭;例如,我们可以让\(V_{s1}\)近似等于0。但是,这会导致非常长的存储和关闭切换时间。如果\(I_{B2}=0\)时,所有存储的少数电荷必须通过重阻(正负电荷结合)被动地去除。从最小化开关时间的角度来看,图4.33的基极电流波形是理想的。初始基极电流\(I_{B1}\)很大,因此电荷会快速插入基极中,导通开关时间也很短。选择一个平衡状态电流的折衷值\(I_{Bon}\),以产生一个相当低的集电极-发射极正向压降,同时保持适量的多余存储少数电荷,从而使存储时间合理地短。电流\(-I_{B2}\)的大小很大,因此电荷从基极快速移走,从而存储和关断开关时间得以最小化。
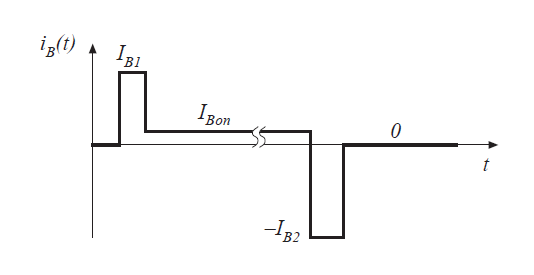
Fig 4.33 Ideal base current waveform for minimization of switching times
不幸的是,在大多数BJT中,必须限制\(I_{B1}\)和\(I_{B2}\)的大小,因为过高的值会导致器件故障。如图4.34所示,基极电流横向流过\(P\)区。该电流导致\(P\)材料电阻的电压降,这会影响基极-发射极结两端的电压。在关断过渡期间,基极电流\(-I_{B2}\)使基极-发射极结电压在基极区域的中心变大,而在基极触点附近的边缘变小。这导致集电极电流集中在基极区域的中心附近。以类似的方式,较大的\(I_{B1}\)导致集电极电流在导通过渡期间拥挤在基极区域的边缘附近。由于在开关转换期间集电极-发射极之间的电压和集电极电流同时较大,因此大量功率损耗可能与电流聚集相关,从而在基极区的中心或边缘处引起热点。基极-发射极结电流的正温度系数(对应于结电压的负温度系数)会导致热失控和器件故障。因此,为了获得可靠的工作,可能有必要限制\(I_{B1}\)和\(I_{B2}\)的大小。可能还需要增加外部缓冲电路,以减少开关转换期间的瞬时晶体管功耗。
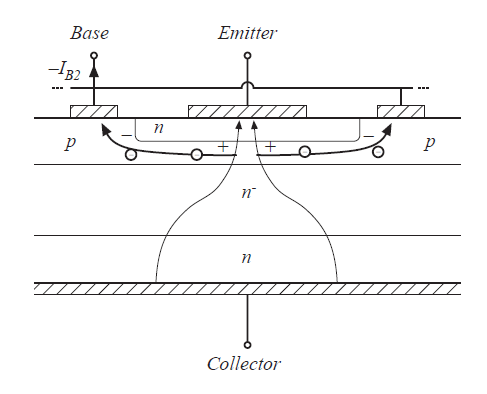
Fig 4.34 A large \(I_{B2}\) leads to focusing of the emitter current away from the base contacts, due to the voltage induced by the lateral base region current
BJT的稳态特性如图4.35所示。在图4.35(a)中,对于不同的集电极-发射极电压值\(V_{CE}\),将集电极电流\(I_{C}\)绘制为基极电流\(I_{B}\)的函数。图中确定了截止,有效,准饱和和饱和区域。在给定的集电极电流\(I_{C}\)以最小的正向压降在饱和区域工作的情况下,基极电流\(I_{B}\)必须足够大。有源区的斜率\(dI_{C}/dI_{B}\)是电流增益\(\beta\)。可以看出,在大电流下,\(β\)减小-在BJT的额定电流附近,电流增益迅速减小,因此很难使器件完全饱和。对于各种\(I_{B}\)值,在图4.35(b)中将集电极电流\(I_{C}\)绘制为集电极-发射极电压\(V_{CE}\)的函数。其中,击穿电压\(BV_{sus}\),\(BV_{CEO}\)以及\(BV_{CBO}\)也被描绘了出来。\(BV_{CBO}\)是发射极开路或基极电流为负值时基极-集电极结的雪崩击穿电压。\(BV_{CEO}\)是基极电流为零时观察到的较小的集电极-发射极击穿电压;随着雪崩击穿的临近,将产生自由载流子,其作用与正基极电流相同,并导致击穿电压降低。\(BV_{sus}\)是在正基极电流下观察到的击穿电压。由于高瞬时功耗,击穿通常会导致BJT损坏。在大多数应用中,截止状态晶体管的电压不得超过\(BV_{CEO}\)。
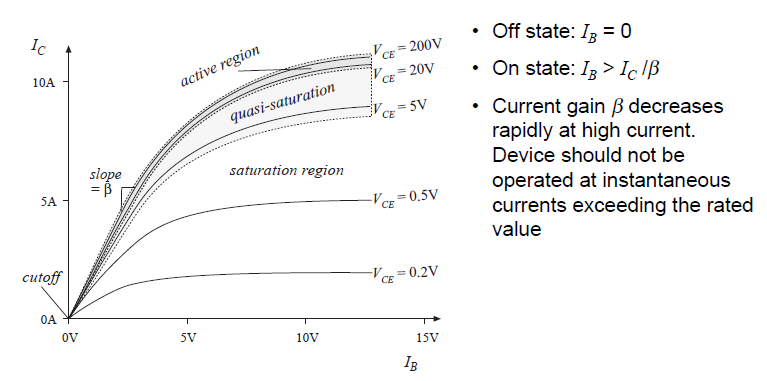
(a)
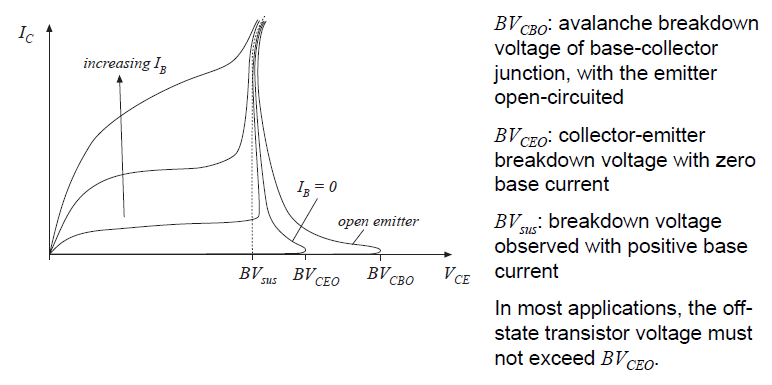
(b)
Fig 4.35 BJT static characteristics: (a) \(I_{C}\) vs. \(I_{B}\), illustrating the regions of operation; (b) \(I_{C}\) vs. \(V_{CE}\),illustrating voltage breakdown characteristics
高压BJT通常具有低电流,因此,达林顿连接的器件(图4.36)很常见。如果晶体管\(Q_1\)和\(Q_2\)分别具有电流增益\(\beta_1\)和\(\beta_2\),则连接达林顿的设备的电流增益(\(\beta_1 +\beta_2 +\beta_{1}\beta_{2}\))将大大增加。在单片达林顿器件中,晶体管\(Q_1\)和\(Q_2\)集成在同一硅晶片上。二极管\(D_1\)通过允许基极驱动器在关断过渡期间主动移除\(Q_1\)和\(Q_2\)的存储电荷,从而加快了关断过程。

Fig 4.36 Darlington-connected BJTs, including diode for improvement of turn-off times
在低于500 V的电压电平时,BJT在电源应用中几乎已完全被MOSFET取代。在新设计采用更快的IGBT或其他器件的更高电压应用中,它也正在被取代。
4.2.4 绝缘栅双极晶体管(IGBT)
IGBT的横截面如图4.37所示。与图4.26相比,IGBT和功率MOSFET在结构上非常相似,主要区别是P区连接到IGBT的集电极。所以IGBT是一个拥有金属氧化物半导体栅极的现代四层功率半导体器件。
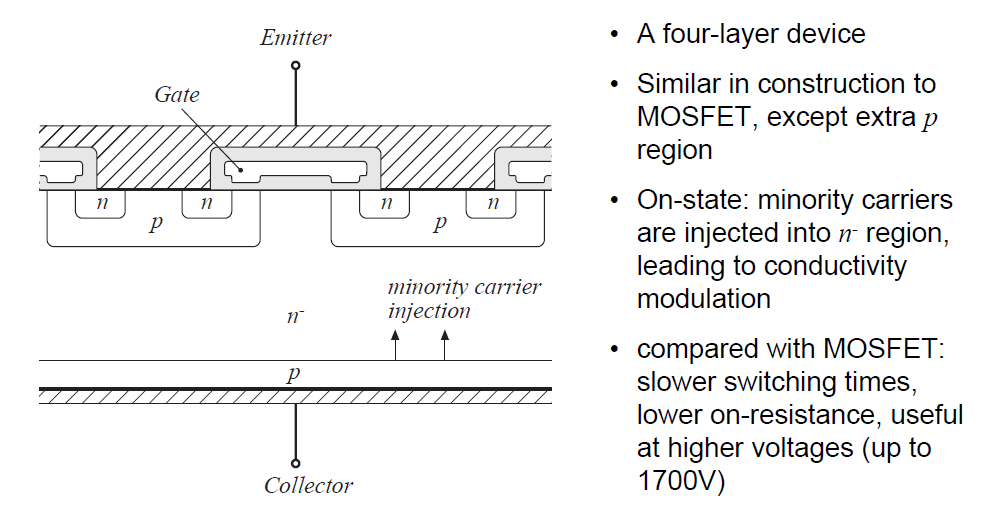
Fig 4.37 IGBT structure. Crosshatched regions are metallized contacts. Shaded regions are insulating silicon dioxide layers.
如图4.37所示,增加的\(P\)区的功能是在器件工作在导通状态时向\(N^{-}\)区域注入少数电荷。当IGBT导通时,\(P-N^{-}\)结是正向偏置的,注入\(N^{-}\)区域的少数电荷引起电导率调制。这降低了\(N^{-}\)区域的导通电阻,并允许构建具有低正向压降的高压IGBT。从1999年开始,低至600伏、高至3300伏的IGBT电压等级已经问世。这些器件的正向压降通常为2至4伏,远低于相同硅面积的等效MOSFET。
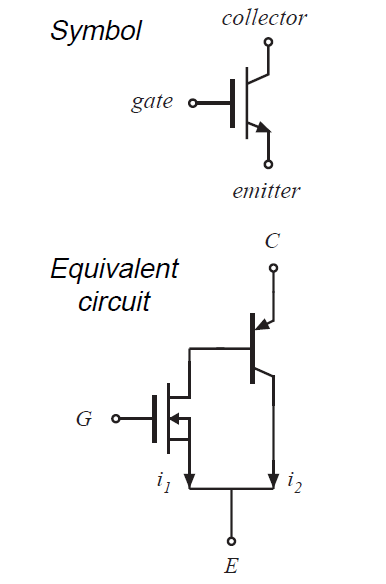
Fig 4.38 The IGBT: schematic symbol and equivalent circuit.
IGBT正在使用的示意符号有若干;图4.38中上面的简化符号最受欢迎。IGBT的双晶体管等效电路如图4.38下所示,IGBT实际上是一个N沟道功率MOSFET和一个PNP发射极跟随器BJT级联而成。其等效电路位置如图4.39所示。可以看出其中有两种有效电流:有效的MOSFET沟道电流\(i_{1}\)和有效的PNP集电极电流\(i_{2}\)。
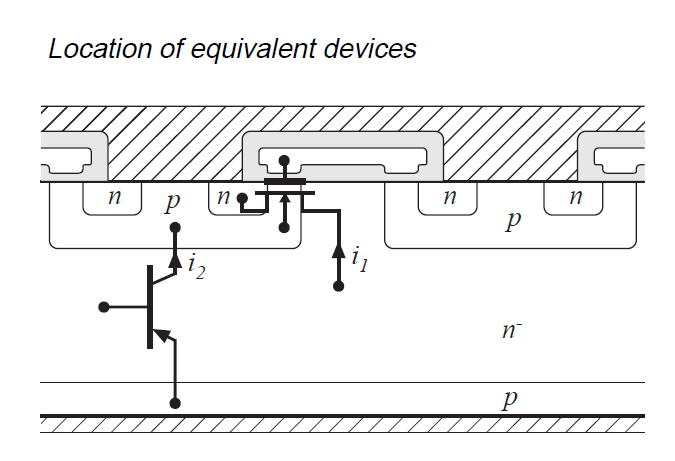
Fig 4.39 Physical locations of the effective MOSFET and PNP components of the IGBT.
IGBT降低电压降的代价是增加了开关时间,尤其是关断器件,特别的其关断特性表现出一种电流拖尾现象。通过消除栅极电荷,使得栅极与发射极的电压为负,可以迅速关断MOSFET。这将会使得沟道电流\(i_{1}\)迅速变为零。然而,只要\(N^{-}\)区域还存在少数电荷,PNP的集电极电流就会继续流动。由于没有办法主动移除存储的少数电荷,他只能通过复合慢慢衰减。因此\(i_{2}\)与少数电荷成比例的缓慢衰减,并且可以观察到电流拖尾现象。电流拖尾的长度可以通过在\(N^{-}\)区域引入复合中心(recombination center)来减小,代价就是会增加导通电阻。PNP晶体管的电流增益也可以最小化,从而使得\(i_{1}\)大于\(i_{2}\)。尽管如此,IGBT的关断开关时间明显长于MOSFET的关断开关时间,典型的关断时间在0.5\(\mu s\)到5\(\mu s\)的范围内。第4.3.1节讨论了IGBT电流拖尾引起的开关损耗。包含IGBTs的脉宽调制变换器的开关频率通常在1至30kHz的范围内。
IGBT增加的\(P-N^{-}\)二极管结通常不能显著的阻断电压。因此IGBT具有可忽略的电压阻断能力。
由于IGBT是四层结构器件,其存在栓锁(Latch-Up)效应,可能会导致器件不能通过栅极电压控制来关断。最新的一些器件不会受到这个问题的影响,这些器件非常的耐用(robust),不存在hot-spot 和current crowding 问题,并且对外部缓冲电路的需求也较小。
IGBT的导通时的正向电压降可以通过与有效导通电阻串联的正偏二极管结来建模。二极管结电压具有负温度系数,而导通电阻具有正温度系数,这使得IGBT正向压降的温度系数变得复杂。幸运的是,在额定电流附近,电阻占主导地位,导致整体呈现正温度系数。因此,IGBT可以很容易地并联,电流降额适中。包含多个并联芯片的大型模块在市场上有售。
表4.3列出了几种商用单芯片和多芯片IGBT模块的特性。
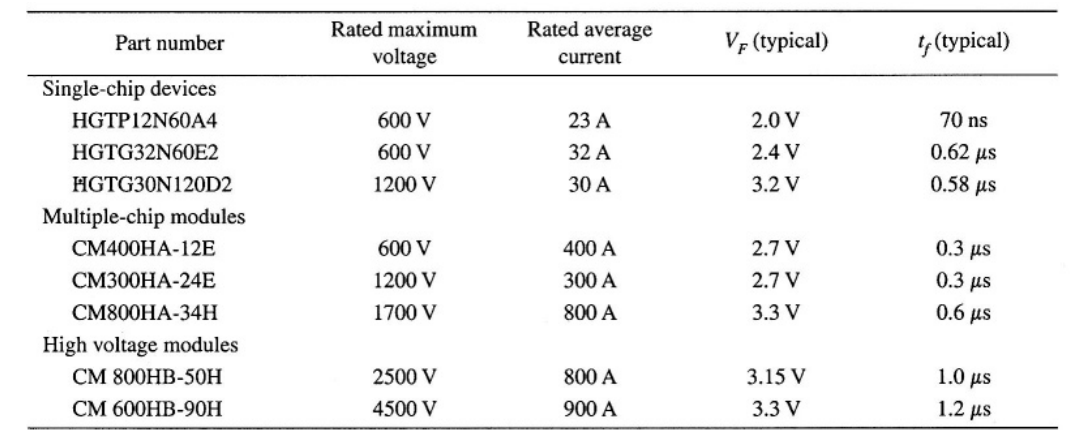
Table 4.3 Characteristics of several commercial IGBTs
4.2.5 晶闸管(SCR,GTO,MCT)
在所有传统的半导体功率器件中,可控硅整流器是最古老的,每额定kVA的成本最低,并且能够控制最大的功率。额定电压为5000到7000伏,额定电流为几千安的设备都是可用的。在公用直流输电线路应用中,串联光触发SCR用于逆变器和整流器,将交流公用系统连接到直流输电线路,直流输电线路的载流量约为1 kA和1 MV。一个大的可控硅填充了一个直径几英寸的硅片,并安装在一个hockey-puck-style的外壳中。

Fig 4.40 The SCR: schematic symbol and equivalent circuit
可控硅的示意符号如图4.40所示,其等效电路包括了NPN和PNP的BJT器件。硅片的横截面如图4.41所示。有效晶体管\(Q_{1}\)由\(N,P\)和\(N^{-}\)区域构成。\(Q_{2}\)由\(P,N^{-}\)和\(P\)区域构成。该器件能够阻挡正负阳极至阴极电压。根据所施加电压的极性,其中一个结将被反向偏置。在任一情况下,耗尽区延伸到轻掺杂\(N^{-}\)区,与其他器件相同,通过适当设计区域厚度和掺杂浓度可以获得所需的击穿电压。
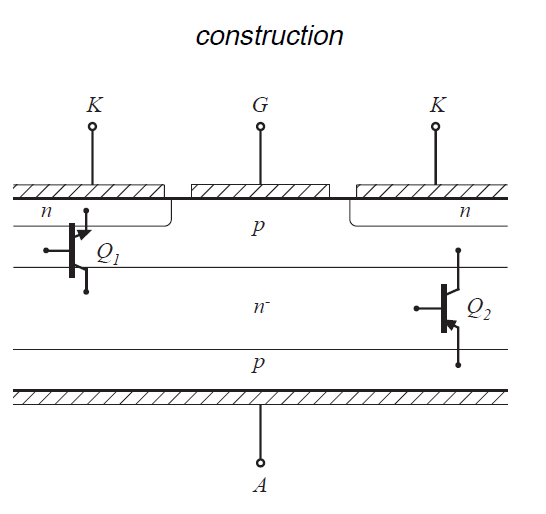
Fig 4.41 Physical locations of the effective NPN and PNP components of the SCR
当施加的阳极-阴极电压\(v_{ak}\)为正时,可控硅可以进入导通状态。正栅极电流\(i_g\)随后导致有效晶体管\(Q_1\)导通;这又向有效晶体管\(Q_2\)提供基极电流,并使其导通。晶体管\(Q_1\)和\(Q_2\)的基极和集电极区域的有效连接构成了正反馈回路。假设两个晶体管的电流增益的乘积大于1,那么晶体管的电流将自发性地增加。在导通状态下,阳极电流受到外部电路的限制,两个有效晶体管完全饱和工作。少数载流子被注入所有四个区域,由此产生的电导率调制导致非常低的正向电压降。在导通状态下,可控硅可以模拟为一个与低导通电阻串联的正向偏置二极管结。无论栅极电流如何,可控硅都被锁定在导通状态:除非施加负阳极电流或负的阳极至阴极电压,否则可控硅不能关断。在相控变换器中,可控硅在变换器交流输入或输出波形的过零点关闭。在强制换向变换器中,外部通信电路通过反转阳极电流或阳极-阴极电压来强制可控硅可控关断。
传统可控硅的\(i_A-v_{ak}\)静态特性如图4.42所示。可以看出,可控硅是一个电压双向的两象限开关。导通变换由栅极电流主动控制。关闭转换是被动的。
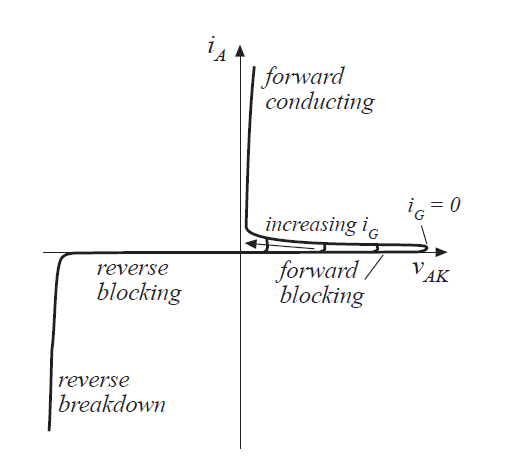
Fig 4.42 SCR的静态\(i_A-v_{ak}\)特性
在关断转换期间,必须限制正向阳极到阴极电压的再施加速率,以避免再次触发可控硅。关断时间\(t_q\)是通过负阳极电流主动移除少数存储电荷以及任何剩余少数电荷复合所需的时间。在关断转变期间,负阳极电流主动移除存储的少数电荷,波形类似于图4.25的二极管关断转变波形。因此,在阳极电流的第一次零穿越之后,有必要等待一段时间,然后再施加正的阳极-阴极电压。因此,有必要限制阳极-阴极电压增加的速率,以避免再次触发器件。逆变器级SCR针对更快的开关时间进行了优化,并且具有更小的\(t_q\)。
传统的SCR晶片具有较大的特征尺寸,栅极和阴极接触的粗糙或不存在。由这种大特征尺寸产生的寄生元件导致若干限制。在导通转换期间,阳极电流的增加速率必须限制在一个安全值。否则会出现阴极电流聚焦,导致热点形成,器件失效。
栅极和阴极结构的粗糙特征尺寸也是阻止常规可控硅由主动栅极控制关闭的原因。人们可以施加负栅极电流,试图主动移除所有少数存储电荷,并反向偏置\(P-N\)栅极-阴极结。这一尝试失败的原因如图4.43所示。大的负栅极电流横向流过相邻的\(P\)区,导致电压下降,如图所示。这导致栅极-阴极结电压在栅极接触附近较小,而在远离栅极接触处相对较大。负栅极电流能够仅反向偏置栅极接触附近的栅极-阴极结的部分;栅极-阴极结的剩余部分继续被正向偏置,阴极电流继续流动。实际上,栅极接触只能影响阴极的附近部分。
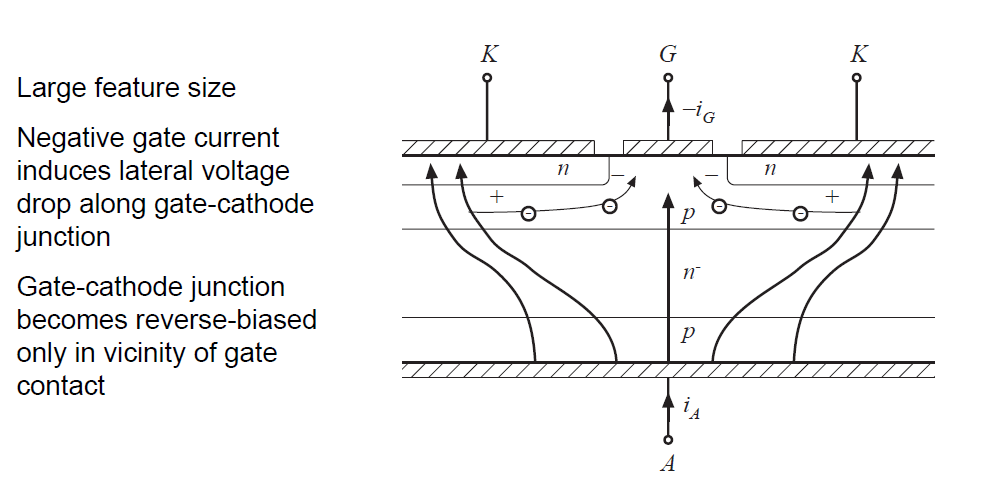
Fig 4.43 Negative gate current is unable to completely reverse-bias the gate-cathode junction. The anode current focuses away from the gate contact.
门极关断晶闸管(GTO)是一种具有小特征尺寸的现代功率器件。栅极和阴极触点高度交叉,因此整个栅极-阴极\(P-N\)结可以在关断转换期间通过负栅极电流反向偏置。像可控硅一样,一个大的GTO可以填充整个硅片。商用GTO的最大电压和电流额定值低于SCR。
GTO的关断增益是导通状态电流与关断器件所需的负栅极电流幅度之比。该增益的典型值为2至5,这意味着关闭传导1000安的GTO可能需要数百A的负栅极电流。最大可控导通状态电流也很重要。GTO能够传导明显大于额定平均电流的峰值电流;然而,当存在这些高峰值电流时,可能无法在栅极控制下关闭器件。
金属氧化物半导体控制的晶闸管,或称MCT,是一种新型的功率器件,其中MOSFET集成在一个高度交叉的晶闸管上,以控制导通和关断过程。像MOSFET和IGBT一样,MCT是一个单象限器件,其导通和关断转换由MOSFET栅极端控制。商用MCT是\(P\)型器件。电压双向两象限MCT和\(N\)型MCT也是可能的。
图4.44示出了包含用于控制导通和关断转变的MOSFET的MCT的横截面。图4.45给出了解释这种结构操作的等效电路。为了导通该器件,栅极到阳极的电压被驱动为负。这将正向偏置BJT Q1的基极-发射极结。晶体管\(Q_1\)和\(Q_2\)随后锁定在导通状态。为了关断该器件,栅极到阳极的电压被驱动为正。这正向偏置了\(N\)沟道场效应晶体管\(Q_4\),反过来反向偏置了BJT \(Q_2\)的基极-发射极结。然后双极晶体管关闭。\(N\)沟道MOSFET的导通电阻必须足够小,以便对阴极电流产生足够大的影响——这限制了最大可控导通状态电流(即通过栅极控制可以断开的最大电流)。
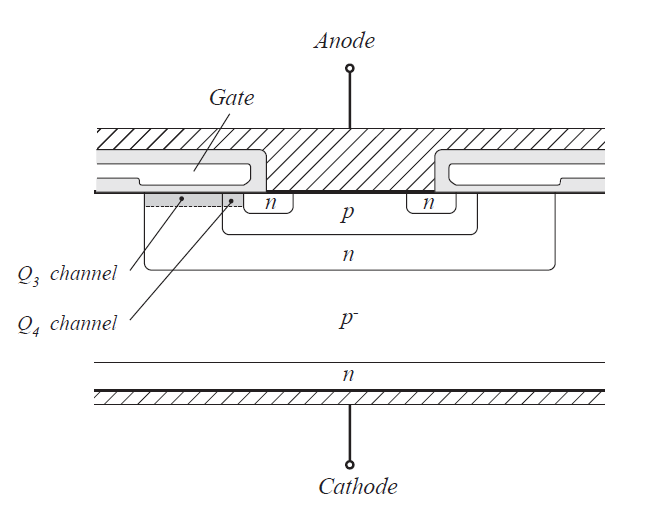
Fig 4.44 MCT structure. Crosshatched regions are metallized contacts. Lightly shaded regions are insulating silicon dioxide layers
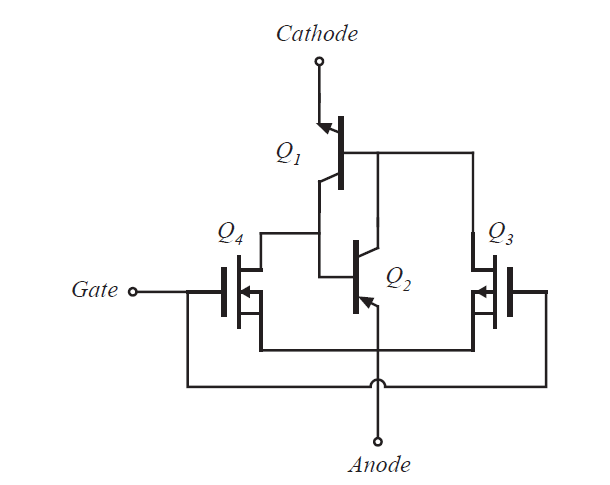
Fig 4.45 Equivalent circuit for the MCT
与具有相似额定电压和硅面积的IGBT相比,高压MCT具有更低的正向压降和更高的电流密度。然而,切换时间更长。像GTO一样,MCT可以传导相当大的浪涌电流;但同样,通过栅极控制可以中断的最大电流是有限的。为了获得可靠的关断转换,需要外部缓冲器来限制阳极至阴极的峰值电压。还需要足够快的栅极电压上升时间。在某种程度上,MCT仍然是一个新兴的设备——未来几代的MCTs可能会在性能和额定值方面有很大的提高。
[Fundamental of Power Electronics]-PART I-4.开关实现-4.2 功率半导体器件概述的更多相关文章
- [Fundamental of Power Electronics]-PART I-4.开关实现-4.3 开关损耗/4.4 小结
4.3 开关损耗/4.4 小结 使用半导体器件实现开关后,我们现在可以讨论变换器中损耗和低效的另一个主要来源:开关损耗.如前所述,半导体器件的导通和关断转换需要几十纳秒到几微秒的时间.在这些开关转换期 ...
- [Fundamental of Power Electronics]-PART I-4.开关实现-0 序
4 开关实现 在前面的章节中我们已经看到,可以使用晶体管,二极管来作为Buck,Boost和其他一些DC-DC变换器的开关元件.也许有人会想为什么会这样,以及通常如何实现半导体的开关.这些都是值得被提 ...
- [Fundamental of Power Electronics]-PART I-1.引言-1.1 功率处理概论
1.1 功率处理概论 电力电子领域关注的是利用电子设备对电力进行处理[1–7].如图1.1所示,其中关键部件就是开关变换器.通常,开关变换器包含电源输入和控制输入端口以及电源输出端口.原始输入功率按控 ...
- [Fundamental of Power Electronics]-PART II-7. 交流等效电路建模-7.3 脉冲宽度调制器建模
7.3 脉冲宽度调制器建模 我们现在已经达成了本章开始的目标,为图7.1推导了一个有效的等效电路模型.但仍存在一个细节,对脉冲宽度调制(PWM)环节进行建模.如图7.1所示的脉冲宽度调制器可以产生一个 ...
- [Fundamental of Power Electronics]-PART I-1.引言-1.2 1.3 电力电子技术的几个应用、本书内容
1.2 电力电子技术的几个应用 高效开关变换器面临的功率范围从 (1)小于1瓦(电池供电的便携式设备内的DC-DC转换器)到(2)计算机及办公设备中的几十,几百,数千瓦到(3)变速电机驱动器中上千瓦及 ...
- [Fundamental of Power Electronics]-PART I-2.稳态变换器原理分析-2.1 引言
2.1 引言 在上一章中,介绍了降压变换器作为降低直流电压的一种方法,其仅使用非耗散开关,电感器和电容器.开关状态变换产生一个矩形波形\(v_{s}(t)\),如图2.1所示.当开关位于位置1时,该电 ...
- [Fundamental of Power Electronics]-PART II-7. 交流等效电路建模-7.4 规范电路模型
7.4 规范电路模型 在讨论了推导开关变换器交流等效电路模型的几种方法后,让我们先停下来,说明下这些结果.所有的在 CCM下以PWM工作的DC-DC变换器都具有相似的基本功能.首先,他们在理想情况下, ...
- [Fundamental of Power Electronics]-PART I-4.开关实现-4.1 开关应用
4.1 开关应用 4.1.1 单象限开关 理想的SPST(Single pole single throw)开关如图4.1所示.开关包含电源端子1和0,其电流和电压极性如图所示.在接通状态下,电压\( ...
- [Fundamental of Power Electronics]-PART II-9. 控制器设计-9.1 引言
9.1 引言 在所有的开关变换器中,输出电压\(v(t)\)都是输入电压\(v_{g}(t)\),占空比\(d(t)\),负载电流\(i_{load}(t)\)和电路元件值的函数.在DC-DC变换器应 ...
随机推荐
- Teadocs & markdown website
Teadocs & markdown website Teadocs 是一款能够帮你快速构建html文档的工具,它基于nodejs编写,并使用markdown来编写文档内容. Teadocs ...
- Docker使用指南
上文简单介绍了docker,这边记录一下docker的使用. 一.Docker启停 1.启动docker systemctl start docker 2.关闭docker systemctl sto ...
- 使用hive增量更新
目录 1.增量更新 2.对第一种情况 2.1.准备工作 2.2.更新数据 3.对第二种情况 3.1.准备工作 3.2.方法1 3.3.方法2 参考文末文章,加上自己的理解. 1.增量更新 有一个 ba ...
- 这一篇TCP总结请收下
前言 很高兴遇见你~ TCP这些东西,基本每个程序猿都或多或少是掌握的了.虽然感觉在实际开发中没有什么用武之处,但,面试他要问啊 而最近大家伙过完年,也都在准备春招,我也一样.阅读了一些okHttp源 ...
- linux系统解压命令总结
原文链接:https://www.cnblogs.com/lhm166/articles/6604852.html tar -c: 建立压缩档案 -x:解压 -t:查看内容 -r:向压缩归档文件末尾追 ...
- python类的内部方法
目录 一.绑定方法与非绑定方法 1.绑定方法 2.非绑定方法 二.property 1.什么是property? 2.为什么要用property? 3.如何使用property? 三.isinstan ...
- spring boot +dubbo 踩坑记录
今天初次搭建spring boot +duboo的demo.记录一下踩坑记录. 首先搭建3个小demo,一个maven项目,两个spring boot (服务提供者和服务消费者)项目. 两 sprin ...
- css常用居中方式
一.水平居中 1.内联元素 父级元素加 text-align: center 即可 html <div class="container"> <a>内联元素 ...
- HDOJ-1260(动态规划水题)
Tickets HDOJ-1260 #include<bits/stdc++.h> using namespace std; const int maxn=2003; int n; int ...
- pygame模块使用时出现AttributeError: module ‘pygame’ has no attribute '…'错误解决方法
pygame模块使用时出现AttributeError: module 'pygame' has no attribute '-'错误解决方法 首先在pygame中存在init()模块,出现这样的问题 ...
